�ֻ��û���
�����Ϸ���ά�����ֻ��У���
��ɨһɨ�����Ͻ�ѡ��
���ѡȡ��ά�������ɡ�
1���ʴ��� ������ǽת�ƹ��պ�self-aligned double patterning��SADP���Ĺ�������ͼ��
����鿴��
����𰸣� �����
�����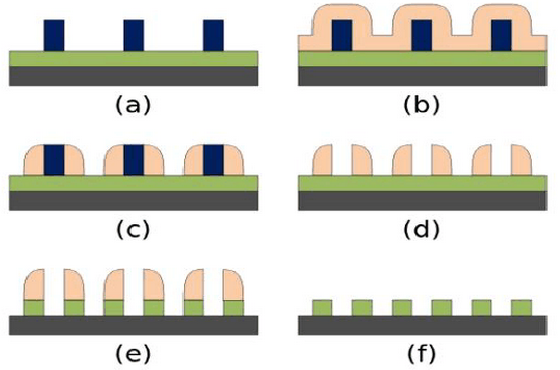
2���ʴ��� �Ӽ�������͵��ݡ���Ǩ��������˵����������У�Back-End-Of-Line��BEOL������ͭ��Cu�������͵ͽ�糣����low-k�����ϵı�Ҫ�ԡ�
����鿴��
����𰸣���������ͼ���������ɵ��ӳ١������ڵ�������л�ײ����
����������������������ͼ���������ɵ��ӳ١������ڵ�������л�ײ�������е����ӣ�������ת�Ƹ����ӴӶ��ƶ����ӷ��������ƶ����������Ϊ��Ǩ�ơ��ڵ�������У���Ǩ�Ʋ��ϻ��ۣ��������ڵ����в�����ɢ��ȱ�ݡ���Щȱ����ϳɴ�Ŀն�����ɶ�·����ˣ���Ǩ��ֱ��Ӱ���·�Ŀɿ��ԡ�����ͭ�����ɴ�����ͽ��������ߵĵ���Ӷ����ٻ�����ɵ��ӳ١�ͭ�ĵ�Ǩ�Ʊ�������С�ࣺܶͭ�ľ�����ɢ�ļ�����Ϊ2.2eV��������ɢ�������0.7��1.2eV֮�䣻�����ֱ�Ϊ1.4eV��0.4-0.8eV.���õͽ�糣���������ƽ�е���֮��Ŀռ�ɽ��ͽ���������֮��ĵ��ݴӶ������ӳ١�����ͭ/low-k�����ɴ����С����pitch���Ӷ����ٻ�������������
3���ʴ��� ����APCVD��LPCVD��PECVD���ص㡣
����鿴��
����𰸣� �����
�����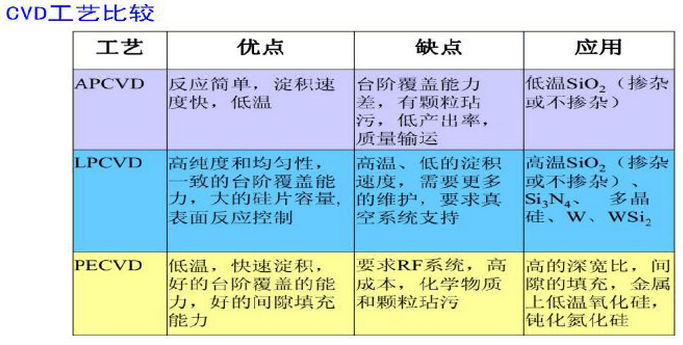 APCVD——һЩ�����CVD�������ڴ���ѹ�½��еģ����ڷ�Ӧ���ʿ죬CVDϵͳ�����ڽϺ�Ľ��ʵ�����APCVDȱ�㣺̨�����ԲĤ������ԲЧ�ʵ͡���ѹ����ɢϵ��С��hg<��LPCVDϵͳ�У���Ϊ��ѹʹ����ɢ�����ӣ����𝒉𝒈���ʹ��𝒉𝒈>>𝒌𝒔�����������ܱ��滯ѧ��Ӧ���ƣ��������ľ������أ���Ƭ������ֱ�������У�������LPCVDȱ�㣺�����������������¶ȸ�
APCVD——һЩ�����CVD�������ڴ���ѹ�½��еģ����ڷ�Ӧ���ʿ죬CVDϵͳ�����ڽϺ�Ľ��ʵ�����APCVDȱ�㣺̨�����ԲĤ������ԲЧ�ʵ͡���ѹ����ɢϵ��С��hg<��LPCVDϵͳ�У���Ϊ��ѹʹ����ɢ�����ӣ����𝒉𝒈���ʹ��𝒉𝒈>>𝒌𝒔�����������ܱ��滯ѧ��Ӧ���ƣ��������ľ������أ���Ƭ������ֱ�������У�������LPCVDȱ�㣺�����������������¶ȸ�
PECVD——����������ǿ��ѧ���������PECVD.��Ŀǰ����Ҫ�Ļ�ѧ�������ϵͳ��APCVD��LPCVD�������������������ά�ֻ�ѧ��Ӧ����PECVD��ͨ����Ƶ���������������ά�ֻ�ѧ��Ӧ���ܼ����ķ��ӿ����ڵ����·�����ѧ��Ӧ�����Ե����¶ȱ�APCVD��LPCVD�ͣ�200-350�棩����������Ҳ���ߣ������ı�Ĥ�������õĸ����ԡ�������ܶȡ����õĽ��ݸ��Ǽ���ѧ���ԡ���Ӧԭ�������������еĵ����뷴Ӧ����ķ�����ײʱ����Щ���ӽ��ֽ�ɶ��ֳɷݣ����ӡ�ԭ���Լ����Ի��ţ�����̬������Щ���Ի��Ų��������ڳĵױ����ϣ������ڱ����ϵĻ��Ի���֮�䷢����ѧ��Ӧ���ɱ�ĤԪ�أ����ڳĵױ������γɱ�Ĥ�����Ի��������ڱ���ʱ�����ϵ��ܵ����Ӻ͵��Ӻ����������Ǩ�ƣ������������С����������Ա�֤����������Ĥ�����õľ����ԣ��Լ����С�ߴ�ṹ������������PECVD��ǵ�������CVD��ȣ����������и���ķ�ƽ���ص㣬��Ҳ���Ը����ظı䱡Ĥ���ʣ���ɡ��ܶȡ�Ӧ���ȣ������Ҷ����ض���Ӧ�ÿ�������Щ���ܡ�Ȼ������Ҳ��ʹ��Ĥ������ϣ���е���ֻ������ʣ��縱��Ʒ��������ӽ�Ͻ���Ĥ��
4���ʴ��� ʲô����ɢЧӦ��ʲô���Բ���ЧӦ��������ЧӦʹ�óĵ�/���ӽ������ʷֲ��������ı仯��
����鿴��
����𰸣���ɢЧӦ��ָ�ĵ��е����������Ӳ��е����ʣ�����������ʱ
����������������ɢЧӦ��ָ�ĵ��е����������Ӳ��е����ʣ�����������ʱ������ɢ������ĵ������Ӳ���渽������Ũ�ȵĻ����仯����ɢЧӦ�Խ������ʷֲ������Ӱ�죬���¶ȡ��ĵ����Ӳ�IJ���������������ͼ���ɢϵ�������Ӳ�������ٶȺ�ȱ�ݵ������йء��Բ���ЧӦ�����������������У��ĵ����Ӳ��е�������������������ѧ��Ӧ�ĸ�����Գĵ����Ӳ�ĸ�ʴ������ʹ�ĵ����Ӳ��е����ʽ���߽���У��ı��˱߽���еIJ��ӳɷֺ�Ũ�ȣ��Ӷ����������Ӳ������ʵ�ʵ�ʷֲ�ƫ�����������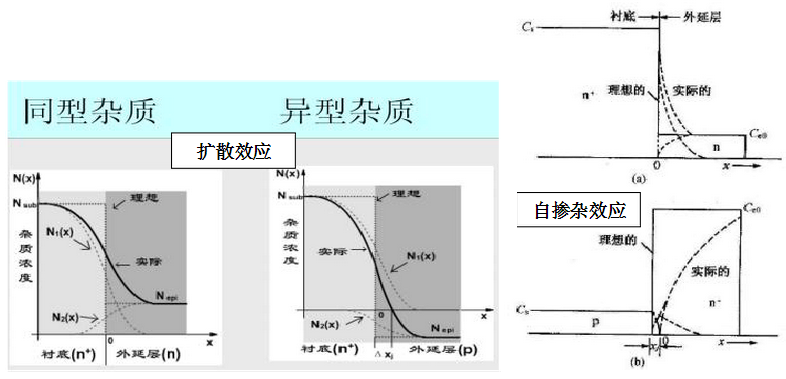
5���ʴ��� ��ͭ�����У�ΪʲôҪ��ͭ��ɢ�赲�㣿�赲��ֳ��ļ��֣��ֱ���ʲô���ã�
����鿴��
����𰸣�1��ͭ��SiO2�м�����ɢ����ɶԹ�������մ�ۣ�����S
��������������1��ͭ��SiO2�м�����ɢ����ɶԹ�������մ�ۣ�����SiO2��©���������ӽ�©�����������˻�����ѹ��
2��ͭ�����������ͱ���ʴ��
3��ͭ��low-k���ճ���ԺܲҪʵ��ͭ���������ҵ�һ����ɢ�赲�㣬��ͭԼ���ڻ����ṹ�У�ͬʱʵ�ַ�ֹͭ��������ʴ����������ʵ�ճ���ԡ�
������ɢ�赲��——ͭ�����ṹӦ�ô�������ɢ�赲���Χ��һ����Ϊ�����赲�㣬һ����Ϊ�����赲�㡣���õ����赲���ԭ���������»�����֮��Ҫ��ͨ�����ܲ��ò�����Ľ������赲�㡣
6���ʴ���
��ͼ�ǹ��鷴Ӧ�����ྦྷ��Ĺ��̣�д��������Ӧ�ķ���ʽ������������1��5�����ĺ��塣
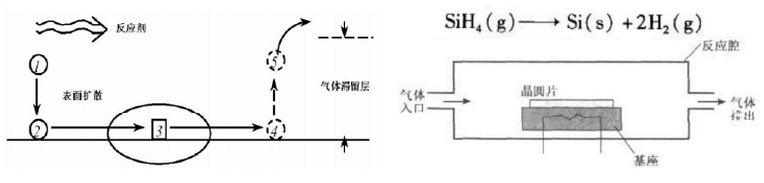
����鿴��
����𰸣���1����Ӧ�����ǻ�������ԲƬ�������ˣ�
����������������1����Ӧ�����ǻ�������ԲƬ�������ˣ�
��2����Щ���巴Ӧ����ϵ�д������ӣ�
��3����Щ��Ӧ�����˵���ԲƬ���棻
��4�����淴Ӧ�ͷų��裻
��5�����帱�����������
��6���������뿪��ԲƬ��������ˣ�
��7���������뿪��Ӧ��������
7���ʴ��� ���ý��似�����ļ��֣��������ǵĹ���ԭ�����ص㡣
����鿴��
����𰸣�ֱ������——�������壬��벣���
��������������ֱ������——�������壬��벣������ѹ�µĽ���ǻ�壬��ѹ���ڵ缫�ϲ����������塣�Ӹ�ֱ����ѹ�ĵ��Ƕ��缫Ϊ��Ҫ������Դ���ϣ�����������ѹ�壬��Ϊ�вġ���Ƭ�����ڵ缫�ϣ���������ײ���вģ��������ԭ�ӣ���Щԭ����������ʽ�����߹���������ײ������Ƭ���棬���۲��γɱ�Ĥ��
��Ƶ����——ֱ�����䷽����ǰ��֮һ�ǰв�Ӧ���нϺõĵ����ԡ���Ƶ������һ���������ڸ��ֽ����ͷǽ������ϵ�һ�ֽ�������������������缫֮����ϸ�Ƶ�糡ʱ����Ϊ��Ƶ�糡���Ծ��������迹��ʽ��Ͻ�������ң�����Ҫ��缫һ���ǵ����塣��Ƶ���������ڰв��ϲ�����ƫѹЧӦ.������Ƶ�糡�����õ�ͬʱ���вĻ��Զ��ش���һ������λ���⽫�����������Ӷ�������Է��ĺ���ͽ��䡣��ʵ��Ӧ���У���Ƶ����Ľ����Թ�ŵ�����l3.56MHz�½��еġ�
��Ӧ����——�����Դ�������Ϊ����вģ����ڹ���������ͨ�������Ļ������壬ʹ���ڽ��������ͬʱ�����ض��Ļ���������ڵ�����ͬʱ�γɻ�����Ľ��似������Ϊ��Ӧ���䷽����
ƫѹ���䣺�����ʴ��ƫѹ������������ʴ���ڵ���ǰ��һ����ʱ���ڣ����ĵͰеĵ�ѧ������ߵ�������ʹ�óĵ�����������ǰвģ��������ԴӾ�ԲƬ����ȥ����Ȼ������Ͳ��������ۡ����ڼĴſ�ϵͳ������ĵ͵��������ǵ��壬���Ե��ڼ��ڳĵ��ϵ�����ڵ��������ƫѹ����Ϊ�����ʴ�ı�Ĥ���ڵ�ƫѹ�¿������µ����ھ�ԲƬ�ϣ�����õ�̨���ǵľ����ơ�
8���ʴ��� ����ij�ֱ�Ĥ��CVD���̣������¶�Ϊ900�棬��������ϵ��hG=10cms-1�����淴Ӧ����ϵ��ks=1��107exp��-1.9eV/kT��cms-1�������������ֵ� ��ϵͳ�ɹ�ѡ��1����ڣ�ʯī֧���ͣ���2���ȱڣ��ѷŹ�Ƭ�͡�Ӧ��ѡ���������͵ĵ���ϵͳ���������ɡ�
����鿴��
����𰸣���Ӧ�������ȱڣ���Ӧ��ǻ�����Ƭ��֧�ż�ͬʱ���ȡ�һ��
����������������Ӧ�������ȱڣ���Ӧ��ǻ�����Ƭ��֧�ż�ͬʱ���ȡ�һ��Ϊ����˿���ȣ��ɾ�ȷ���Ʒ�Ӧǻ�¶Ⱥ;����ԡ��ʺ϶��¶ȿ���Ҫ����̵Ļ�ѧ��Ӧ���Ƶ���ϵͳ��ǻ�ڸ�����������Ĥ��������ڣ����Թ�Ƭ��֧�ż����ȣ�һ����÷��ռ��Ⱥ���Ƶ���ȣ������¿��٣����¶Ⱦ����Բ�ʺ϶��¶�Ҫ�ߵ��������˿��ơ����ϵͳ�ܹ������ڲ���ϵĵ�������С�˷�Ӧ������ģ�Ҳ��С���Ͽ�������Ե�����Ĥ������Ӱ�졣
9���ʴ��� MEMSSi�ӹ�������Ҫ��Ϊ�����࣬�����������������ʲô��
����鿴��
����𰸣�Si���� �����е�ӹ����գ�Bulkmicromac
��������������Si���� �����е�ӹ����գ�Bulkmicromaching��——�þ�Բ��������������MEMS�ṹ���ƣ������������������ȡ��ܺ�Ľṹ������е�ӹ����գ�Surfacemicromachining��——��IC���ռ��� ���������� �赲������ �������ͷŹ���
10���ʴ���
����CF4��Ϊ����Դ��SiO2���п�ʴ���ڽ����зֱ����O2��H2�Կ�ʴ������ʲôӰ�죿����O2��H2�����������ӣ���Si��SiO2��ʴѡ���������仯��Ϊʲô��
����鿴��
����𰸣����������������ܹ����Si��SiO2�Ŀ�ʴ���ʡ������������������������������ܹ����Si��SiO2�Ŀ�ʴ���ʡ������������������Ե���Si��SiO2�Ŀ�ʴ���ʼ�����ԭ����������̼ԭ�ӷ�Ӧ����CO��CO2����˴ӵ���������ȥ����һЩ̼���Ӷ������˷���Ũ�ȡ���Щ���������Ϊ�����������塣������֮���Si�Ŀ�ʴ����������SiO2�Ŀ�ʴҪ�졣�������Ӻ�������һ��ֵ���ߵĿ�ʴ���ʿ�ʼ�½�������Ϊ����ķ�ԭ���ٽ���γɷ�����ʹ�����ɷ�ԭ�Ӽ��ٵ�Ե�ʡ���һ������ߵ�ѡ���Ҳ�ἱ���½�����Ϊ�����ڹ�������ԭ�Ӻ������ӻ�ʹ�ù���ֵø���������衣�����������м����⣬��������Ӧ��һ��������˷����ӵ�Ũ�ȣ������˿�ʴ���ʡ���һ�����γɸ�̼�������壬����̼�ᵼ�·ǻӷ��Ե������ۻ��ڲ�ڱ��棬���ͺ����ʴ�ķ�������CF4���������м���������H2�����¹�Ͷ�������Ŀ�ʴ����ͬʱ���������еȵ�H2Ũ���£�H��F��Ӧ����HF��HF��ʴSiO2��������ʴSi��ͬʱ���������ԵIJ��ӷ���̼�������ﱡĤ�ĵ������̵õ���ǿ����һ���棬SiO2���淴Ӧ���ɵ�CO��CO2���Դ�ϵͳ�г�ȥ����Si����ȷû����Щ��Ӧ����ˣ�����H2�ļ��룬��ʴSiO2��Si��ѡ��Ȼἱ��������
11���ʴ��� ��Ƶ�ŵ���ֱ���ŵ�����к��ŵ㣿
����鿴��
����𰸣�ֱ���ŵ��У�����ڱ���Ļ��ۻ�ʹ�糡��С��ֱ����������
��������������ֱ���ŵ��У�����ڱ���Ļ��ۻ�ʹ�糡��С��ֱ������������ʧ������Ƶ�糡�У���Ϊ�糡�����Եظı䷽�������Ӳ�������缫�����ڶ��뿪�ŵ�ռ䣬��Եؼ����˴������ӵ���ʧ��������֮�䲻�����˶��ĵ��ӿ��ԴӸ�Ƶ�糡�л���㹻������ʹ������ӵ��룬ֻҪ�нϵ͵ĵ糡�Ϳ���ά�ַŵ硣���������Ķ��ε��ӷ��䲻������������ı�Ҫ��������Ƶ�糡����ͨ���κ�һ�����͵��迹��Ͻ�������ң����Ե缫�����ǵ��壬Ҳ���Ǿ�Ե�塣
12���ʴ���
Si-SiO2���������ļ��֣���������Դ�������취��

����鿴��
����𰸣��ɶ����ӵ��Qm��Դ����Ҫ��Դ��Na+������ı��ߡ���
���������������ɶ����ӵ��Qm��Դ����Ҫ��Դ��Na+������ı��ߡ�����취��Ϊ�˽���Na+�����ۣ������ڹ��չ����в�ȡԤ����ʩ������ʹ�ú��ȵ��������գ������������Ե���ϴ�ܵ���¯�ܺ���ص���������ʹ�ó������Ļ�ѧ���ʣ��ܱ�֤���弰���崫����̵���ࡣ���Ᵽ֤դ���ϲ�������Ҳ�Ǻ���Ҫ�ġ�������������Qot��Դ��������������Щȱ���ܲ������壬��Щȱ���У������Ҽ����ڽ������壻�ݹ�-�������չ���ܶϼ�����ԭ�ӣ��������Ҽ����������Ĺ�-��������Ǻ��������ѣ�����ֵ�ѧ���ԣ�����Ť���Ĺ�-��������Si-H��Si-OH����
���������ɵķ�ʽ��Ҫ�е��������ȵ���ע���
����취�����ٵ�����������ɵ���Ҫ���������֣���ѡ���ʵ����������������Ը���SiO2�ṹ��Ϊ�����գ�������ѹ�������������1000��������������ڶ��������н��е����˻�150-400�棩���Լ��ٵ���������塣�۲��öԷ��ղ������Ķۻ��㣬����A12O3��Si3N4�ȡ�������̶����Qf��Դ��ͨ������Si-SiO2֮��������Ľṹ�ı�����ġ������д����й�ʣ�Ĺ����ӣ��������������뾧���ѿ�����δ��ȫ������Ӧ�������취�������˻�����Ч�ؼ�С������̶�����ܶȡ���ͼΪDeal���ǣ�˵��������ЧӦ������������Qit��Դ�����洦���ڵIJ��������ϼۼ������ͼ���ʹ�õ��ӺͿ�Ѩ���Ժ����ر��������취������̬�ܶ���ĵ��������������������˻����������йء�����ͬ�Ĺ��������¡���111������Ĺ�ĵײ����Ľ���̬�ܶ���ߣ���100���������͡�ͨ������������˻��տ�����Ч���ٽ���̬�ܶȡ�
13���ʴ��� ʲô�ǹ������ӣ�SPE�������������д��ڵ����⣿
����鿴��
����𰸣�����������ָ�뵼�嵥���ϵķǾ����ڵ��ڸò��ϵ��۵��
������������������������ָ�뵼�嵥���ϵķǾ����ڵ��ڸò��ϵ��۵�����¶��������ٽᾧ�Ĺ��̡��������Ӵ�������——���ĩ��ȱ��EOR����ע���ʹ��Ǿ��������ȶ���λ�����Ǹ���ע���һ��ͻ���ص㣬�Ǿ����Թ������ӷ�ʽ������λ���������Ũ���ڷǾ��;����Ľ��档��Щλ������ķǾ�/������a/C.�����ȱ�ݳ�Ϊ���ĩ�ˣ�EOR��End-of-RangE.ȱ�ݡ��γ����ĩ��ȱ�ݵ�ԭ������a/c�����һ���д����ķǾ�����ֵ���ˡ���λ����λ��PN��ľ�����������������©������λ������������ʽ��ʱ�����ء�ѡ����˻����Ӧ���ܹ������㹻��������ɢ��ʹλ�������ڸ߲�������ͬʱ�ֱ��赲����������ʱ�ĺľ���֮�⡣
14���ʴ��� ����ԭ�ӵ���ɢ��ʽ���ļ��֣����Ǹ��Է�����������ʲô����ԭ����ɢ�ĽǶȾ���˵��������ǿ��ɢ������������ɢ�Ļ�����
����鿴��
����𰸣��ٽ���ʽ��������ԭ���������㹻�ߵ����������ཻ��λ�á�
���������������ٽ���ʽ��������ԭ���������㹻�ߵ����������ཻ��λ�á��ڿ�λʽ�������о����λ������ԭ�����ƶ�����������϶ʽ���ڿ�϶�е�ԭ�Ӽ�������ԭ�Ӻ�ռ����λ����������ԭ����ȥ��������ԭ�ӡ����ڿ�϶�е�ԭ���ھ����ԭ�Ӽ�϶�п����ƶ�һ�ξ�������ջ�ռ�ݿ�λ����������ԭ��ռ����λ�����ϼ�����ʽ��Ҫ�ֳ������ࣺ����λʽ��ɢ������϶ʽ��ɢ����λʽ��ɢ�����λ���ʵĽ���û�п�λ.����λ����Ҫ�˶������ھ���λ���ϣ��ͱ���ͨ�����λ����ʵ�֡����ֻ�λ��������Χ�������ܴ�Ļ��䣬��Ҫ�൱������������ֻ�е���λ���ʵĽ��ھ����ϳ��ֿ�λ����λʽ��ɢ�űȽ�����������϶����ɢ�������ƣ��������˶������ШD�߳�������λ���ϵĹ�ԭ�ӽ��뾧��λ�ã���Ϊ��λ���ʣ����D�߳�����ԭ�ӱ�Ϊ��϶ԭ�ӣ�Frank-Turnbull���ƣ�Ҳ���ܱ��D�߳����������Լ�϶��ʽ������ɢ�˶�������������λʱ�ɱ�����Ϊ��λ���ʡ�
15���ʴ���
����������˻����ԡ�
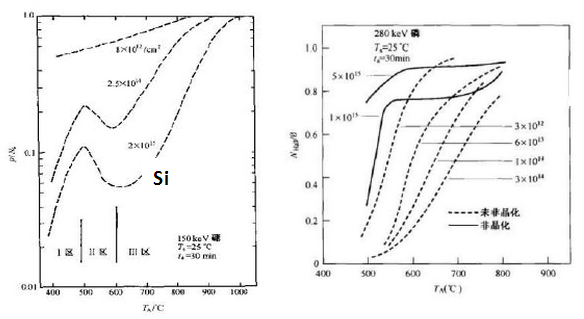
����鿴��
����𰸣����˻����Ե缤�������������������p��ע�����Ns�ı�
�����������������˻����Ե缤�������������������p��ע�����Ns�ıȶ��ڵͼ�������������˻��¶��������缤����������ڸ�������������˻��¶ȷ�Ϊ��������������I�У����˻��¶���������ȱ�ݵ��ƶ�������ǿ����˼�϶���ԭ�����λ�ĸ��ϼ������ӣ�ʹ��ȱ����ʧ����λ���Ũ���������缤��������ӣ�����������Ũ�������˻��¶���500-600��ķ�Χ�ڣ���ȱ��ͨ��������ϻ���ţ���������������Ϊ��ԭ�ӷdz�С����ȱ�����к�ǿ�����ã�������Ǩ�ƻ�ϵ�ȱ�����У����ڷǼ���λ�ã�����������¶ȵ����߶���λ���Ũ���½�������Ҳ��������������Ũ�����¶��������½����������˻����ԣ�����������У������λŨ���Խӽ���5eV�ļ��������¶����������ӣ����������������ʱSi������λ�IJ������ƶ����� ��һ�¡������Ŀ�λ���϶���˶��������϶��Ϳ��Խ����λ��������λλ�ã���ĵ缤�����Ҳ���¶����������ӡ�ʵ���˻�������Ҫ����ע��ʱ���¡�ע��������Բ������ܵ�Ҫ����ѡ��ע������ͣ����������˻������˻��¶Ȳ���Ҫ̫�ߡ�1012/cm2��800�ȣ������ӡ�
����ע������½ϸ�ʱע��ʱ�������Ǿ������ٽ������ͬ���˻�Ҫ��Ҳ��ͬ�����˻�����ͼ����������ʾ������������û�б�Ϊ�Ǿ���ʱ���˻����ʣ�ʵ�����ʾ�Ǿ�����˻����ʡ�����1X1015/cm2��5X1015/cm2ʱ���γɵķǾ��㣬�˻��¶���600�����ң����ڼ���Ϊ1014����û���γɷǾ���ʱ���˻��¶ȣ�������Ϊ����������˻������ͬ���Ǿ�����˻�ЧӦ�������������������������ϵ�ģ��������������У�V��ԭ��ʵ�������ԭ�����������֣���ע���V��ԭ��P���ٽᾧ���������ԭ��һ����ͬʱ����ϵ�����λ���ϡ�
16���ʴ��� ����������SiO2�Ĵ�����ʽ����ε���SiO2���������ʡ�
����鿴��
����𰸣����������п��ܴ��ڸ������ʣ�ijЩ�������������ˮ�й�
�����������������������п��ܴ��ڸ������ʣ�ijЩ�������������ˮ�йصĻ������ṹ��ͼ��ʾ���������������������ˮ���ڣ�һ�ֿ��ܷ����ķ�Ӧ��һ�����Ż�ԭΪ������������Si��O��Si→Si��O��H+H��O��Si���繹����——һЩ���ʻᱻ��������ȵ���SiO2�У��������������������ʺ͵�ѧ���ԣ��������ף���Ϊ���繹���ߣ����ǿ��Ե��������ź������ŵı�����ʹ��SiO2��ǿ�����������½�����B���Si֮�����ϵ��ĸ�Oֻ������O����ͬB�γɹ��ۼ���ʣ���һ��O���������ĵ�B�γɹ��ۼ���������˷��ż�O�����SiO2�����з��ż�O���ӣ�ǿ���½�����P���Si֮����ԭ�е��ĸ�O�γɹ��ۼ���������һ���۵��ӣ��������ļ۵��ӻ���������ڵ�һ�����ż�O�γ��ż�O�����SiO2����ǿ�����ӡ�����ı���——������SiO2�����϶������Ϊ����ı��ߡ�һ����������ʽ���ڣ����Ӱ뾶�ϴ������Ŀ����Ժ�С������Na��K��Pb��Ba�ȶ�������ı��ߡ�����ı�����������������ʽ����SiO2�С���������֮����뻯�����������ӽ���SiO2���硣Na2O+ΞSi-O-SiΞ→Si–O-+Osup>—<SiΞ+2Na+�������������ӣ�ʹ���ż�����Ũ������SiO2�����ǿ�ȼ�����
17���ʴ��� һƬ��Ƭ��0.3um���SiO2��Ĥ���ǡ��������ݼ��±���������������k=1.38��10-23����1����1200���£�����H2O������ʹ�������0.5um��Ҫ����ʱ�䣿����2����1200���£����ø�������������ͬ���ĺ����Ҫ����ʱ�䣿
����鿴��
����𰸣� �����
�����
18������� �о�ϸ���ṹ�����쳣�뼲����ϵ��ϸ������ѧ��֧��Ϊ������
����鿴��
����𰸣�ϸ������ѧ
��������������ϸ������ѧ
19���ʴ��� ʲô������ע���г������Ĺ���ЧӦ��Channeling�����ٽ�ǣ����������ЧӦ��
����鿴��
����𰸣�����ЧӦ���Ծ���н�������ע�룬�������ٶȷ���ƽ������
������������������ЧӦ���Ծ���н�������ע�룬�������ٶȷ���ƽ����������ʱ���������ܵ�����ײ�����ӽ��ع����˶���ע����Ⱥ�����ڹ���ЧӦ��ʹע������Ũ�ȵķֲ������ܳ�����β��������ԭ��ע�뵽��ԭ�Ӱ�ʱ����βЧӦ�������ԡ�����취��A.ƫ����ע�룬����7°����б�ǣ�����������ȫ��������ЧӦ��B.ע��ǰ�ƻ�����ṹ��ʹ��Si��F��Ar����ע����ɹ��Ԥ�Ǿ�����C.ʹ�ñ������������㣬ʹ���ӽ��뾧��ǰ���ٶȷ����������Ὣ������ע�뾧�塣��1��ƫ��ע�룺һ��ѡȡ5��7��ǣ���������ԽС���������Խ��2 ���ĵǾ���Ԥ����������һ�θ���Ar+ע�룬ʹ�����Ǿ�����3���Ǿ���ɢ�䣺��������200��250Å�������裨ScreenOxidE.��ʹ�������ӽ���辧��ǰ��������4��ע�����ʵ��ԷǾ���ЧӦ�������ʣ�As��������ע�롣
20���ʴ��� �ڸɷ���ʴ���յ��ⷽ���У���ѧ����Ƶ����������������乤��ԭ������ȱ�㡣
����鿴��
����𰸣���ѧ����Ƶ���������ü�����������ij�ֲ����Ĺ���ǿ��
����������������ѧ����Ƶ���������ü�����������ij�ֲ����Ĺ���ǿ�ȱ仯���ﵽ�յ����Ŀ�ġ���ǿ�ı仯��ӳ�˵���������ԭ�ӻ����Ũ�ȵı仯�����ݼ��IJ�ͬ���ʻ��п�ʴ�յ��ǿ�������������״̬�����ڲ�ͬ�Ŀ�ʴ��Ĥ���ʴ�����ж�Ӧ����Ҫ���IJ�������Ӱ���ʴ�Ľ��У��ҿɶ�С�仯������Ӧ����ǿ�����ڿ�ʴ���ʣ���˶Կ�ʴ���ʽ����ķ�ӳ���Լ�⡣��ʴ�����Сʱ���ź�ǿ�Ȳ���Ҳ�ᵼ�¼�����ѣ���SiO2�Ӵ����Ŀ�ʴ��
21���ʴ���
��ͼΪһ�����͵�����ע��ϵͳ����1������1~6���ֱ�ʶ���ֵ����ƣ����������á���2����������2�Ĺ���ԭ����

����鿴��
����𰸣�1.����Դ2.�����ſ�3.������4.������բ5.x&a
��������������1.����Դ2.�����ſ�3.������4.������բ5.x&yɨ���6.�����ڱ�
1.����Դ���ã�����ע���õ�����ԭ�������ܵ��Ӻ�������ӷŵ磩����ԭ���γ�ע���������ͣ���Ƶ�������� ��������������һ���ŵ�ǻ�ң��ȵ�˿����ĵ��������������ײ���������㹻��ʱ��������ӱ��뻯��2.�������������ã����������ӷ�ѡ����ԭ�������������ڴų��������״������ã��˶��켣��������������Դ���������������и��ֳɷ֣����д�����ǵ���ģ���BF3�������У�������Ҫ������ѡ��B+�������Ĺ���ͨ����һ������������ɡ�����������һ����ѹǻ���ڣ���ǻ���ڵĴų�����ֱ�����������ٶȷ������ôų��Ժ��ʱȲ�ͬ�����Ӳ�����ƫת���ô�С��ͬ��������ض�λ�ò���һ�����죬���Խ���������ӷ�������� 3.���������ã�ʹ���ӻ�������������ԭ��������ǿ����ʹ���ӻ�ø�����ٶȼ���������Ҫ������ʹ�����������������ܹ��ﵽ��������Ҫ�Ľ����һ�龲���������۽�Ϊһ��Բ����״��Ȼ��������һ�����Ծ�����������������ؼ��ٹܵij��ȷ�����һ���糡���ı����ӵ�������4.������բ�������������ã�ʹ����ԭ������ֱ��ǰ�����ܴﵽ����ԭ������һ����ƫת��ʹ������ƫת5º--8º�����ٽ������5.ɨ��ϵͳ���ã�ʹ������������Ƭ�Ͼ���ע�롣��ʽ���ٰ�Ƭ��ֹ����������X��Y��������ɨ�衣����������Y��������ɨ�裬��Ƭ��X��������е�˶�������������ֹ����Ƭ��X��Y��������е�˶���6.�����ڱ����ã��ռ���������ע�����ԭ�����ռ�����������ʱ����л��ֵõ������Ĵ�С��Ϣ
3.���������ã�ʹ���ӻ�������������ԭ��������ǿ����ʹ���ӻ�ø�����ٶȼ���������Ҫ������ʹ�����������������ܹ��ﵽ��������Ҫ�Ľ����һ�龲���������۽�Ϊһ��Բ����״��Ȼ��������һ�����Ծ�����������������ؼ��ٹܵij��ȷ�����һ���糡���ı����ӵ�������4.������բ�������������ã�ʹ����ԭ������ֱ��ǰ�����ܴﵽ����ԭ������һ����ƫת��ʹ������ƫת5º--8º�����ٽ������5.ɨ��ϵͳ���ã�ʹ������������Ƭ�Ͼ���ע�롣��ʽ���ٰ�Ƭ��ֹ����������X��Y��������ɨ�衣����������Y��������ɨ�裬��Ƭ��X��������е�˶�������������ֹ����Ƭ��X��Y��������е�˶���6.�����ڱ����ã��ռ���������ע�����ԭ�����ռ�����������ʱ����л��ֵõ������Ĵ�С��Ϣ
22���ʴ��� �ֱ�������ʿ���˫����ʿ�﹤������ͼ��
����鿴��
����𰸣� �����
�����
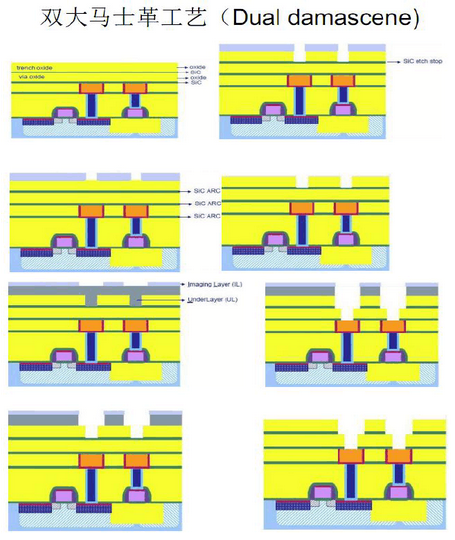
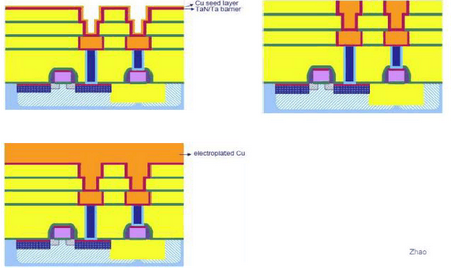
23���ʴ��� CVD����������������Ҫ�����Ʋ�����ʲô�����Ƿֱ���ʲô����»�֧�������������ʣ�
����鿴��
����𰸣�CVD���̰����������֣�һ����Ӧ���ڱ߽���е����˶���
��������������CVD���̰����������֣�һ����Ӧ���ڱ߽���е����˶�����Ӧ���ڳĵױ���Ļ�ѧ��Ӧ�������ּ����������hg>>ks��Cs����Cg�����������ܱ��滯ѧ��Ӧ���ʿ��ơ���Ӧ�����������������˵���Ƭ����ĩ����滯ѧ��Ӧ����Ҫ�Ģ�hg<<ks��Cs����0�����������������������ʿ��ơ���Ӧ�����������滯ѧ��Ӧ����Ҫ�ĩ����������˵���Ƭ����Ģ���Դ��www.91exam.org��������£����滯ѧ��Ӧ���ʿ���ks=k0e−EA/KT�����������¶ȵ����߶���ָ�����ӡ��ڸ�������£��������˿������ڷ�Ӧ�ٶȵļӿ죬���˵�����ķ�Ӧ���������ڸ��¶��±��滯ѧ��Ӧ����Ҫ����������ʱ�ĵ������ʽ�תΪ���������˿��ƣ������������¶ȱ仯���仯��
24���ʴ��� ʲô������ע��ĺ���ЧӦ��ͬ������ע��ʱ��As��B���ֺ���ЧӦ����Ϊʲô��
����鿴��
����𰸣�����ЧӦ��ע��������ڴ�ֱ�����䷽��ƽ���ڵķֲ������
������������������ЧӦ��ע��������ڴ�ֱ�����䷽��ƽ���ڵķֲ����������ЧӦ��ע�����ӵ���������������йء�B�ĺ���ЧӦ������Ϊ����С�������ٶȸ��ߣ���в�ԭ������ʱ��̡�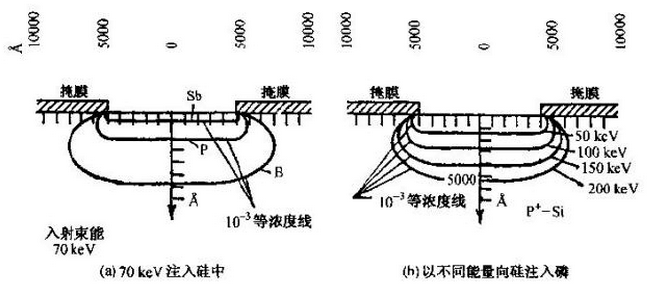
25���ʴ��� �����������������������ٷֲ������ֿ��������
����鿴��
����𰸣����������е����ʷֲ��Ǿ��ȵģ����������������ֲ�����
�����������������������е����ʷֲ��Ǿ��ȵģ����������������ֲ������κ����ʣ����ٷֲ������ֿ��ܡ��ٷ���ϵ��m��l������SiO2��������ɢ�����ʣ�Ҳ����˵�ڷ�������������ͨ��SiO2������ʧ�ĺ��٣�������������ࡣ�ٷֲ�֮�����洦��SiO2�е�����Ũ�ȱȹ��иߣ�����渽����Ũ���½�����m��1������SiO2���ǿ���ɢ�����ʡ���Ϊ����������ͨ��SiO2�����ܵ�������ȥ��������ʧ�dz�������ʹSiO2�е�����Ũ�ȱȽϵͣ�����Ҫ��֤�������ߵ�����Ũ�ȱ�С��1��ʹ����������Ũ�ȼ��������㣬��H2�����е�������������������m��1������SiO2������ɢ�����ʡ��ٷֲ�֮�����渽��������Ũ�����ߣ��������������ʡ���m��l������SiO2�п���ɢ�����ʡ�����������£���Ȼ����ϵ������1�������������ͨ��SiO2������������ж���ʧ����������ֻ�ܲ��ϵؽ���SiO2�У����ܱ��ֽ�����������Ũ�ȱȵ��ڷ���ϵ��������ʹ����渽��������Ũ�ȱ����ڻ�Ҫ�ͣ��ؾ��������������͵����ʡ�����m��1������Ҳû�����ʴ�SiO2������ɢ�����������������Ҳͬ��ʹ���������Ũ�Ƚ��͡�������Ϊһ������Ĺ辭��������֮��ת��Ϊ�����������SiO2���ɴˣ�Ҫʹ�������߾�����ȵ�����Ũ�ȣ�m��1������ô���ʱض�Ҫ�Ӹ�Ũ�ȹ������Ũ��SiO2����ɢ��������Ҫ����һ�����������ʣ��Բ������ӵ�SiO2�������Ҫ�����ʡ�
26���ʴ��� �ֱ����RVD��GILD��ԭ�������ǵ���ȱ�㼰Ӧ�÷���
����鿴��
����𰸣�����������ӣ�RVD��RapidVapor-phase
������������������������ӣ�RVD��RapidVapor-phaseDoping�����ÿ����ȴ������̣�RTP�������ڲ��Ӽ������еĹ�Ƭ���پ��ȵؼ���������Ҫ���¶ȣ�ͬʱ���Ӽ�������Ӧ��������ԭ�ӣ�����ԭ��ֱ�Ӵ���̬ת��Ϊ������������Ĺ�̬��Ȼ����й�����ɢ����ɲ���Ŀ�ġ�ͬ��ͨ��ɢ¯�еIJ��Ӳ�ͬ��������������ڹ�Ƭ�����ϲ�δ�γɺ������ʵIJ����㣻ͬ����ע����ȣ��ر�����dz���Ӧ���ϣ���RVD������DZ�������ǣ���������ע����������һЩЧӦ��Ӱ�죻����ѡ����ɢ��˵�����ÿ���������ӹ�������Ҫ��Ĥ�����⣬�������������ȻҪ�ڽϸߵ��¶�����ɡ����ʷֲ��Ƿ������ָ����ʽ�����ƹ�̬��ɢ�����ֵ���ڱ��洦�������û������ӣ�GILD��GasImmersionLaserDoping�������Ӽ�������308nm�������������ܶȣ�0.5—2.0J/cm2���Ķ����壨20-100ns�����⣬���䴦����̬Դ�еĹ���棻�������������������ΪҺ��㣻ͬʱ��̬����Դ�����Ƚ�������ò�������ԭ�ӣ�ͨ��Һ����ɢ������ԭ�ӽ�������ܱ���Һ��㣬�ܽ���Һ����е�������ɢ�ٶȱ��ڹ����и߰˸����������ϣ�������ʿ��ٲ����ȵ���ɢ�������ۻ����С�
����������ֹͣ���Ѿ��������ʵ�Һ���ͨ����������ת��Ϊ��̬�ᾧ�塣��Һ���Ϊ��̬�ᾧ����ٶȷdz��졣�ڽᾧ��ͬʱ������Ҳ���뼤��ľ���λ�ã�����Ҫ��һ���˻���̣����Ҳ���ֻ�����ڱ����һ�����ڡ����ڹ�����ܸ��ܼ��������ʱ��̣ܶ����������ּ��������������գ��������Դ��ڵ���״̬�����ᷢ����ɢ�������ڵ����ʷֲ�û���ܵ��κ��Ŷ���������ܻ��������ɼ�����������������ʱ������������ˣ��ɸ�����Ҫ���Ƽ��������ܶȺ�����ʱ��ﵽ���Ʋ�����ȵ�Ŀ�ġ�
27���ʴ��� ������������̵Ĺ�դɨ�跽����ʸ��ɨ�跽���к�����
����鿴��
����𰸣��ڹ�դɨ�跽���У�ÿһ�����ر��뱻���ɨ�衣�������ع�
���������������ڹ�դɨ�跽���У�ÿһ�����ر��뱻���ɨ�衣�������ع�ʱ�伸����ͼ���أ�ͼ�ξ���ͨ���رտ���д�����ġ����Ѿ�������������һ��ʸ��ɨ�跽�����ǽ�ÿ����Ҫ�ع����������λ�ô���x��y��/ģת������DAC.��������ָֻ����Щ��Ҫ�ع�����ء�ʸ��ɨ��ϵͳ���ڹ�դ������Ҫ�ŵ����ڽ�������ƫתʱ�������С����һ���棬ͼ�ε�ַ���ȼ�ȡ�������ֵ��ֳ���ʹ�ø��ٿ��ֳ�DAC���ܹ���ÿ�����ط���һ����ϸС�ĸ���ϡ�
28���ʴ��� ˵��SiO2�Ľṹ�����ʣ��������ᾧ��SiO2������SiO2������
����鿴��
����𰸣��ᾧ��SiO2——��Si-O��
���������������ᾧ��SiO2——��Si-O�������ڿռ�������й���ÿ�����ǵ�Oԭ���������������������ĵ�Siԭ���γɹ��ۼ�������SiO2——Si-O������Ŀռ�����û�й���Si-O-Si���ŵĽǶȲ��̶�����110-180°֮�䣬��ֵ144°������SiO2�����ʣ�Si-O�������ڿռ����������O�����ڵ�����Si-O�������Si�γɹ��ۼ�����Ϊ�ż�������Ҳ��һ����ֻ��һ��Si-O�������Si�γɹ��ۼ�����Ϊ���ż������������������ɡ������ȡ��п���SiO2����Լռ��������ռ����43%���ܶ�2.15-2.25g/cm3�ᾧ��SiO2�ܶ�Ϊ2.65g/cm3������SiO2�����У������˶���1-2��Si-O������Si��4��Si-O�������ף�������Si-O���Թ��ۼ�Ϊ����Ҳ�������Ӽ��ɷݣ����¶ȵ����ߣ����Ӽ��ɷݱ��������ܶȣ�һ��Ϊ2.20g/cm3�����Σ�һ���ó������������������ʣ��Dz����ĺ�����5500Å����ʱΪ1.46���ܶȽϴ��������ʽϴ������ʣ����¸����������Ʊ���SiO2�����ʸߴ�1016Ω·cm�����ǿ�ȣ���λ��ȵ�SiO2���ܳ��ܵ���С������ѹ�������̶ܳȡ������ԡ����ʺ����������йأ�һ��Ϊ106-107V/cm����ѧ���ʣ��dz��ȶ���������ֻ������ᷢ����Ӧ��
29���ʴ��� ����BOE����BHF����ʴSiO2��ԭ����
����鿴��
����𰸣��������踯ʴ�����ʪ����ʴ����֮һ����
���������������������踯ʴ�����ʪ����ʴ����֮һ����ϡ�͵�HF�ܼ��н��е�SiO2ʪ����ʴ�������ø�ʴҺ�����6��1��10��1��50��1����ζ��6�ݣ�10�ݻ�50�ݣ��������ˮ��һ��HF��ϡ��������ܷ�Ӧ���£�SiO2+6HF→H2SiO6+2H2Oʵ�ʷ�Ӧʱ���Ǹ�ʴҺ�е�HF����������������Ӻͷ�����HF←→H++F−����F−����������е�һ��Si+4������ɸ����۵����������������[��SiF6��2-]����������H+��ϣ������������ᣨH2SIF6������Ȼ��Ӧ������𝐅−��𝑯++��Ũ���йأ�����ڸ�ʴ������ͨ���������泥�𝐍𝐇4𝐅����Ϊ�������𝐍𝐇4𝐅�ܹ���������𝐅−�Բ������ŷ�Ӧ�ƽ������ٵ�𝐅−��������ʹHF����ƽ�������ƶ���������Һ��PHֵ���Լ��ḯʴҺ�Թ�̽��ĸ�ʴ���á�����𝐍𝐇4𝐅��HF��Һ��ΪBOE��bufferedoxideetching����BHF��bufferedHF.��
30���ʴ��� �������ӱ�Ĥ���������̣�����������������ʲô��
��Դ:91������
����鿴��
����𰸣��������̣��ٴ��䣺��Ӧ������ྭ�߽��ת�Ƶ�Si���棻
���������������������̣��ٴ��䣺��Ӧ������ྭ�߽��ת�Ƶ�Si���棻����������Ӧ��������Si���棻�ۻ�ѧ��Ӧ����Si������л�ѧ��Ӧ���õ�Si����������������������������������ݳ��������ĸ�����ӱ���ת�Ƶ����࣬�ݳ���Ӧ�ң��ӽӣ����ɵ�Siԭ�Ӽӽӵ���������ϣ������ĵ���
���������������ά�IJ�㳤������Ĺ����������������ϵ��������ʾ��ƽ̨��Ťת��̨��
�������ԭ��A���ֲ�����������ԭ�ӿ��Ա������������γɹ贮��赺�������Ĺ贮�ںϲ�ʱ���ض���������ص�ȱ�ݻ��γɶྦྷ��Ĥ��
�������ԭ�Ӿ��бȽϸߵ���������ô���ԭ�Ӹ����������ű���Ǩ�ƣ����Ǩ�Ƶ�һ��̨�ױ�Ե��λ�ã���ͼBλ�ã�����Si-Si��������ã�λ��B��λ��A���ȶ�������ԭ�Ӿ��кܴ�Ŀ����Ա����ڴ�λ�á�����ԭ�����ȶ���λ������ν��Ťתλ�ã���ͼ�е�λ��C��������ԭ�ӵ���һ��Ťתλ��ʱ���γ���һ���Si-Si������һ����Ǩ�ƾͲ�̫���ܷ����ˡ��ڼ������� �����У����������ԭ�ӱض���Ǩ�Ƶ�Ťתλ�ã��Ӷ����뵽�����ı�Ĥ�С�
����Կ�������
��ɨ�·���ά�����ɴ�����������桶
��뵼��оƬ���칤�����
�ֻ��û��������Ϸ���ά�����ֻ��У�����ɨһɨ�����Ͻ�ѡ�����ѡȡ��ά�������ɡ�
����Կ�������
��ɨ�·���ά�����ɴ�����������桶
�뵼��оƬ���칤���뵼�����켼������⣬
�������ִ𰸽����Ű桢С���巽���ӡ���ǣ�������Ա����ʵս���飬�˷�������ͨ���ʴ����ߣ������������Թ��ص������������ֻ��û���
�����Ϸ���ά�����ֻ��У���
��ɨһɨ�����Ͻ�ѡ��
���ѡȡ��ά�������ɡ�