点击进入《★半导体芯片制造工》题库
点击进入《半导体芯片制造工:半导体制造技术》考试资料下载,在线测试
1、问答题 浸没式光刻机相对于传统的光刻机有何不同。
点击查看答案
本题答案:根据瑞利判据: 试题答案根据瑞利判据:
试题答案根据瑞利判据: 要提高分辨率,可以通过增大数值孔径NA来实现。传统曝光设备在镜头与硅片之间的介质是空气,空气的折射率是1;浸液式光刻机采用一种高折射率的介质代替空气,那么NA就能够提高。
要提高分辨率,可以通过增大数值孔径NA来实现。传统曝光设备在镜头与硅片之间的介质是空气,空气的折射率是1;浸液式光刻机采用一种高折射率的介质代替空气,那么NA就能够提高。
2、问答题 什么是离子注入中常发生的沟道效应(Channeling)和临界角?怎样避免沟道效应?
点击查看答案
本题答案:沟道效应:对晶体靶进行离子注入,当离子速度方向平行于主
本题解析:试题答案沟道效应:对晶体靶进行离子注入,当离子速度方向平行于主晶轴时,将很少受到核碰撞,离子将沿沟道运动,注入深度很深。由于沟道效应,使注入离子浓度的分布产生很长的拖尾,对于轻原子注入到重原子靶时,拖尾效应尤其明显。解决办法:A.偏离轴注入,采用7°的倾斜角,但并不能完全消除沟道效应。B.注入前破坏晶格结构,使用Si、F或Ar离子注入完成硅的预非晶化。C.使用薄的屏蔽氧化层,使离子进入晶体前的速度方向无序化,但会将部分氧注入晶体。(1)偏轴注入:一般选取5~7倾角,入射能量越小,所需倾角越大(2)衬底非晶化预处理:进行一次高剂量Ar+注入,使硅表面非晶化(3)非晶层散射:表面生长200~250Å二氧化硅(ScreenOxidE.,使入射离子进入硅晶体前方向无序化(4)注入杂质的自非晶化效应:重杂质(As),高剂量注入。
3、问答题 集成电路制造中有哪几种常见的扩散工艺?各有什么优缺点?
点击查看答案
本题答案:扩散工艺分类:按原始杂质源在室温下的相态分类,可分为固
本题解析:试题答案扩散工艺分类:按原始杂质源在室温下的相态分类,可分为固态源扩散,液态源扩散和气态源扩散。固态源扩散(1).开管扩散优点:开管扩散的重复性和稳定性都很好。(2).箱法扩散优点;箱法扩散的硅表面浓度基本由扩散温度下杂质在硅中的固溶度决定,均匀性较好。(3).涂源法扩散缺点:这种扩散方法的表面浓度很难控制,而且又不均匀。(4).杂质源也可以采用化学气相淀积法淀积,这种方法的均匀性、重复性都很好,还可以把片子排列很密,从而提高生产效率,其缺点是多了一道工序。液态源扩散液态源扩散优点:系统简单,操作方便,成本低,效率高,重复性和均匀性都很好。扩散过程中应准确控制炉温、扩散时间、气体流量和源温等。源瓶的密封性要好,扩散系统不能漏气。气态源扩散气态杂质源多为杂质的氢化物或者卤化物,这些气体的毒性很大,且易燃易爆,操作上要十分小心。快速气相掺杂(RVD)气体浸没激光掺杂(GILD)
4、问答题 一片硅片由0.3um厚的SiO2薄膜覆盖。所需数据见下表,玻尔兹曼常数k=1.38×10-23。(1)在1200℃下,采用H2O氧化,使厚度增加0.5um需要多少时间?。(2)在1200℃下,采用干氧氧化,增加同样的厚度需要多少时间?
点击查看答案
本题答案: 试题答案
试题答案
5、问答题 分别简述RVD和GILD的原理,它们的优缺点及应用方向。
点击查看答案
本题答案:快速气相掺杂(RVD,RapidVapor-phase
本题解析:试题答案快速气相掺杂(RVD,RapidVapor-phaseDoping)利用快速热处理过程(RTP)将处在掺杂剂气氛中的硅片快速均匀地加热至所需要的温度,同时掺杂剂发生反应产生杂质原子,杂质原子直接从气态转变为被硅表面吸附的固态,然后进行固相扩散,完成掺杂目的。同普通扩散炉中的掺杂不同,快速气相掺杂在硅片表面上并未形成含有杂质的玻璃层;同离子注入相比(特别是在浅结的应用上),RVD技术的潜在优势是:它并不受注入所带来的一些效应的影响;对于选择扩散来说,采用快速气相掺杂工艺仍需要掩膜。另外,快速气相掺杂仍然要在较高的温度下完成。杂质分布是非理想的指数形式,类似固态扩散,其峰值处于表面处。气体浸没激光掺杂(GILD:GasImmersionLaserDoping)用准分子激光器(308nm)产生高能量密度(0.5—2.0J/cm2)的短脉冲(20-100ns)激光,照射处于气态源中的硅表面;硅表面因吸收能量而变为液体层;同时气态掺杂源由于热解或光解作用产生杂质原子;通过液相扩散,杂质原子进入这个很薄的液体层,溶解在液体层中的杂质扩散速度比在固体中高八个数量级以上,因而杂质快速并均匀地扩散到整个熔化层中。
当激光照射停止后,已经掺有杂质的液体层通过固相外延转变为固态结晶体。由液体变为固态结晶体的速度非常快。在结晶的同时,杂质也进入激活的晶格位置,不需要近一步退火过程,而且掺杂只发生在表面的一薄层内。由于硅表面受高能激光照射的时间很短,而且能量又几乎都被表面吸收,硅体内仍处于低温状态,不会发生扩散现象,体内的杂质分布没有受到任何扰动。硅表面溶化层的深度由激光束的能量和脉冲时间所决定。因此,可根据需要控制激光能量密度和脉冲时间达到控制掺杂深度的目的。
6、问答题 物理气相淀积最基本的两种方法是什么?简述这两种方法制备薄膜的过程。
点击查看答案
本题答案:物理气相淀积:蒸发Evaporation、溅射Sput
本题解析:试题答案物理气相淀积:蒸发Evaporation、溅射Sputtering热蒸发法:在真空条件下,加热蒸发源,使原子或分子从蒸发源表面逸出,形成蒸气流并入射到衬底表面,凝结形成固态薄膜。溅射概念与机理:基本原理,真空腔中有一个平行板等离子体反应器,非常类似于简单的反应离子刻蚀系统。
将靶材放置在具有最大离子电流的电极上,高能离子将所要淀积的材料从靶材中轰击出来。靶与晶圆片相距十分近(小于10cm),出射原子大部分能被晶圆所收集。
7、问答题 简述RTP在集成电路制造中的常见应用。
点击查看答案
本题答案:1)杂质的快速热激活RTP工艺最具吸引力的的热点之一是
本题解析:试题答案1)杂质的快速热激活RTP工艺最具吸引力的的热点之一是晶圆片不用达到热平衡状态,意味着电活性的有效掺杂实际上可以超过固溶度限制。例如,对砷进行数毫秒的退火,它的激活浓度可达到3×1021左右,大约是其固溶度的10倍。因为,在短时间的退火过程中,砷原子没有足够的时间来形成聚团并凝聚成无活性的缺陷。
2)介质的快速热加工快速热氧化(RTO)可以在合适的高温下通过精确控制的气氛来实现短时间生长薄氧层。(干氧方法)RTO生长的氧化层具有很好的击穿特性,电性能上坚固耐用。由于不均匀温度分布产生的晶圆片内的热塑应力影响了RTO的均匀性。若适当冷却反应腔壁,可以用作冷壁工艺,防止腔壁污染后续工艺。3)硅化物和接触的形成快速热处理也经常被用于形成金属硅化物接触,其可以仔细控制硅化反应的温度和环境气氛,以尽量减少杂污染,并促使硅化物的化学配比和物相达到最理想的状态。形成阻挡层金属也是RTP在Si技术中的一个应用,这些导电的阻挡层金属可以阻止硅衬底和用于器件互联的Al基合金之间的互扩散。另外RTP还可以在GaAs工艺中用于接触的形成,淀积一层金锗混合物并进行热退火,可以在N型GaAs材料上形成低阻的欧姆接触。
8、问答题 简述APCVD、LPCVD、PECVD的特点。
点击查看答案
本题答案: 试题答案
试题答案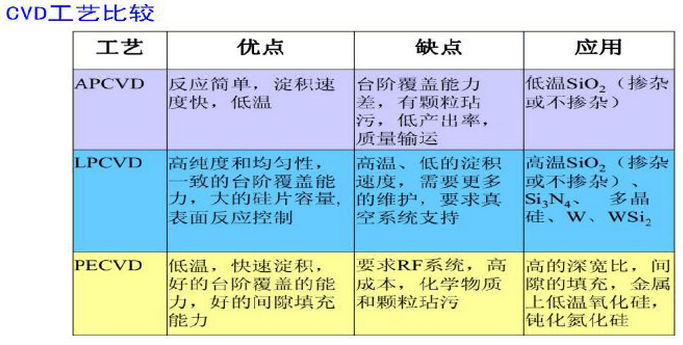 APCVD——一些最早的CVD工艺是在大气压下进行的,由于反应速率快,CVD系统简单,适于较厚的介质淀积。APCVD缺点:台阶覆盖性差;膜厚均匀性差;效率低。常压下扩散系数小,hg<在LPCVD系统中,因为低压使得扩散率增加,因此𝒉𝒈变大使得𝒉𝒈>>𝒌𝒔,生长速率受表面化学反应控制,与气流的均匀性无关,硅片可以竖直紧密排列,容量大。LPCVD缺点:淀积速率慢,生长温度高
APCVD——一些最早的CVD工艺是在大气压下进行的,由于反应速率快,CVD系统简单,适于较厚的介质淀积。APCVD缺点:台阶覆盖性差;膜厚均匀性差;效率低。常压下扩散系数小,hg<在LPCVD系统中,因为低压使得扩散率增加,因此𝒉𝒈变大使得𝒉𝒈>>𝒌𝒔,生长速率受表面化学反应控制,与气流的均匀性无关,硅片可以竖直紧密排列,容量大。LPCVD缺点:淀积速率慢,生长温度高
PECVD——等离子体增强化学气相淀积(PECVD.是目前最主要的化学气相淀积系统。APCVD和LPCVD都是利用热能来激活和维持化学反应,而PECVD是通过射频等离子体来激活和维持化学反应,受激发的分子可以在低温下发生化学反应,所以淀积温度比APCVD和LPCVD低(200-350℃),淀积速率也更高,淀积的薄膜具有良好的附着性、低针孔密度、良好的阶梯覆盖及电学特性。反应原理:等离子体中的电子与反应气体的分子碰撞时,这些分子将分解成多种成份:离子、原子以及活性基团(激发态),这些活性基团不断吸附在衬底表面上,吸附在表面上的活性基团之间发生化学反应生成薄膜元素,并在衬底表面上形成薄膜。活性基团吸附在表面时,不断的受到离子和电子轰击,很容易迁移,发生重新排列。这两个特性保证了所淀积薄膜有良好的均匀性,以及填充小尺寸结构的能力。由于PECVD与非等离子体CVD相比,淀积过程有更多的非平衡特点,故也可以更容易地改变薄膜性质(组成、密度、应力等),并且对于特定的应用可修正这些性能。然而,这也会使薄膜产生不希望有的组分或者性质,如副产品或气体分子结合进薄膜。
9、问答题
下图为硅外延生长速度对H2中SiCL4摩尔分量的函数曲线,试分析曲线走势,并给出其变化的原因。
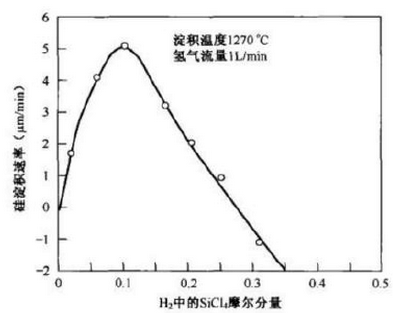
点击查看答案
本题答案:SiCL4浓度较小,SiCL4被氢还原析出硅原子的速度
本题解析:试题答案SiCL4浓度较小,SiCL4被氢还原析出硅原子的速度远小于被释放出来的硅原子在衬底上生成单晶硅速度,化学反应速度控制外延层的生长速率;增加SiCL4浓度,化学反应速率加快,生长速度提高。浓度大到一定程度,化学反应释放硅原子速度大于硅原子在衬底表面的排列生长速度,此时生长速率受硅原子在衬底表面排列生长的速度控制。进一步增大SiCL4浓度(Y=0.1)生长速率减小;当Y=0.27时,逆向反应发生硅被腐蚀;反向腐蚀越严重,生长速率下降,当Y>0.28时,只存在腐蚀反应。
10、问答题 离子在靶内运动时,损失能量可分核阻滞和电子阻滞,解释什么是核阻滞、电子阻滞?两种阻滞本领与注入离子能量具有何关系?
点击查看答案
本题答案:①碰撞注入离子与靶内原子核之间的相互碰撞。因注入离子与
本题解析:试题答案①碰撞注入离子与靶内原子核之间的相互碰撞。因注入离子与靶原子的质量一般为同一数量级,每次碰撞之后,注入离子都可能发生大角度的散射,并失去一定的能量。②子碰撞注入离子与靶内自由电子以及束缚电子之间的碰撞,这种碰撞能瞬时地形成电子-空穴对。由于两者的质量相差非常大(104),每次碰撞中,注入离子的能量损失很小,而且散射角度也非常小,也就是说每次碰撞都不会改变注入离子的动量,虽然经过多次散射,注入离子运动方向基本不变。在一级近似下,核阻止本领与能量无关;电子阻止本领与能量的平方根成正比。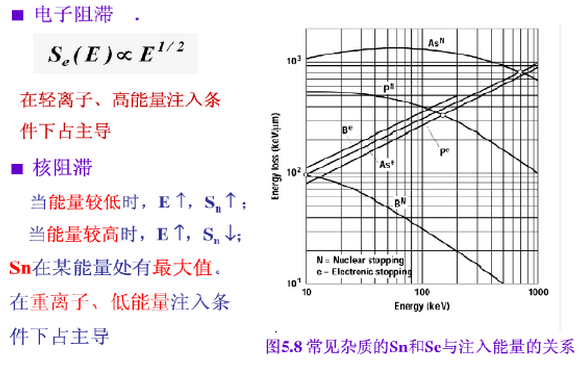
11、问答题 什么是固相外延(SPE)及固相外延中存在的问题?
点击查看答案
本题答案:固相外延是指半导体单晶上的非晶层在低于该材料的熔点或共
本题解析:试题答案固相外延是指半导体单晶上的非晶层在低于该材料的熔点或共晶点温度下外延再结晶的过程。固相外延存在问题——射程末端缺陷EOR高剂量注入促使硅非晶化,而稳定的位错环是高剂量注入的一个突出特点,非晶区以固相外延方式生长后,位错环的最大浓度在非晶和晶体硅的界面。这些位于最初的非晶/单晶(a/C.界面的缺陷称为射程末端(EOR,End-of-RangE.缺陷。形成射程末端缺陷的原因在于a/c界面的一侧有大量的非晶化阈值损伤。若位错环位于PN结耗尽区附近,会产生大的漏电流。位错环与金属杂质结合时更严重。选择的退火过程应当能够产生足够的杂质扩散,使位错环处于高掺杂区,同时又被阻挡在器件工作时的耗尽区之外。
12、填空题 研究细胞结构和功能异常与疾病关系的细胞生物学分支称为()。
点击查看答案
本题答案:细胞病理学
本题解析:试题答案细胞病理学
13、问答题 影响外延薄膜的生长速度的因素有哪些?
点击查看答案
本题答案:1)温度高温区B区,生长速率对温度的变化不敏感,生长速
本题解析:试题答案1)温度高温区B区,生长速率对温度的变化不敏感,生长速率由气相质量输运控制,并且对反应室的几何形状和气流有很大的依赖性。低温区A区,生长速率对温度的变化非常敏感,生长速率完全由表面化学反应控制。外延温度选在高温区:生长速率处于质量输运控制范围,温度的微小波动不会影响生长速率显著变化;淀积在表面的硅原子具有足够的能量和迁移能力,易找到合适的位置形成单晶;外延温度太高,会使自掺杂效应和扩散效应加重。
2)反应剂浓度外延生长速率由以下两因素较慢放入一个决定:氢还原𝐒𝐢𝐂𝐥4析出硅原子的速率;被释放出来的硅原子在衬底上生成单晶层的速率。𝐒𝐢𝐂𝐥4浓度较小,𝐒𝐢𝐂𝐥4被氢还原析出硅原子的速度远小于被释放出来的硅原子在衬底上生成单晶硅速度,化学反应速度控制外延层的生长速率;增加𝐒𝐢𝐂𝐥4浓度,化学反应速率加快,生长速度提高。浓度大到一定程度,化学反应释放硅原子速度大于硅原子在衬底表面的排列生长速度,此时生长速率受硅原子在衬底表面排列生长的速度控制。进一步增大𝐒𝐢𝐂𝐥4浓度(Y=0.1)生长速率减小;当Y=0.27时,逆向反应发生硅被腐蚀;
反向腐蚀越严重,生长速率下降,当Y>0.28时,只存在腐蚀反应。
3)气流速率气体流速越大,边界层越薄,相同时间内转移到单位衬底表面上的反应剂数量越多,外延层生长速率也越快;当气流大到一定程度时,外延层的生长速率基本不随气体流量增大而加快。因为此时边界层厚度很薄,输运到衬底表面的反应剂数量可能超过外延温度下的化学表面反应需要的数量,此时生长速率由化学反应速率决定。
4)衬底晶向不同晶面的键密度不同,键合能力存在差别,会对生长速率产生一定影响。共价键密度小,键合能力差,生长速率慢,例如(111)晶面;共价键密度大,键合能力强,生长速率快,例如(110)晶面。
14、问答题 画出侧墙转移工艺和self-aligned double patterning(SADP)的工艺流程图。
点击查看答案
本题答案: 试题答案
试题答案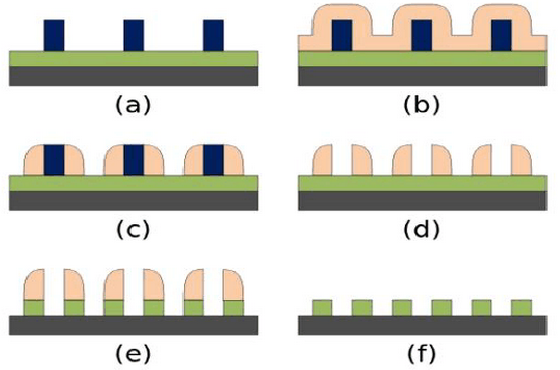
15、问答题 以P2O5为例,多晶硅中杂质扩散的方式及分布情况。
点击查看答案
本题答案:在多晶硅薄膜中进行杂质扩散的扩散方式与单晶硅中的方式是
本题解析:试题答案在多晶硅薄膜中进行杂质扩散的扩散方式与单晶硅中的方式是不同的,因为多晶硅中有晶粒间界存在,所以杂质原子主要沿着晶粒间界进行扩散。主要有三种扩散模式:①晶粒尺寸较小或晶粒内的扩散较快,以至从两边晶粒间界向晶粒内的扩散相互重叠,形成如图A类分布。②晶粒较大或晶粒内的扩散较慢,所以离晶粒间界较远处杂质原子很少,形成如图B类分布。③与晶粒间界扩散相比,晶粒内的扩散可以忽略不计,因此形成如图C类分布。所以多晶扩散要比单晶扩散快得多,其扩散速度一般要大两个数量级。
16、问答题 说明影响氧化速率的因素。
点击查看答案
本题答案:1)氧化剂分压因为平衡情况下,SiO2中氧化剂的浓度C
本题解析:试题答案1)氧化剂分压因为平衡情况下,SiO2中氧化剂的浓度C0=HPg,而抛物型速率常数B=2DSiO2C0/N1,所以气体中的氧化剂分压Pg是通过氧化剂的浓度对速率常数B产生影响,B与Pg成正比关系。A与氧化剂分压无关。因为B、B/A均与Pg成正比,那么在一定氧化条件下,通过改变氧化剂分压可达到改变二氧化硅生长速率的目的。2)氧化温度对抛物线性速率系数B的影响是通过氧化剂在SiO2中扩散系数DSiO2C0/N1产生的。由B=2DSiO2C0/N1可知,B与温度之间也是指数关系。对线性速率系数B/A的影响线性速率常数B/A与温度的关系如图,对于干氧氧化和水汽氧化都是指数关系,激活能分别为2.00eV和1.96eV,其值接近Si-Si键断裂所需要的1.83eV的能量值,说明支配线性速率常数B/A的主要因素是化学反应常数ks,ks与温度的关系为:ks=ks0exp(-Ea/kT)其中,ks0为实验常数,Ea为化学激活能。3)晶向抛物型氧化速率常数B,与硅衬底晶向无关,这是因为在氧化剂压力一定的条件下,B的大小只与氧化剂在SiO2中的扩散能力有关.线性氧化速率常数B/A则强烈地依赖于晶面的取向,因为在氧化剂分压不是很低时气相质量输运系数h>>ks,在这种情况下线性氧化速率常数的大小主要由化学反应常数ks决定,即由硅表面处的原子经化学反应转变为SiO2的速率决定。表面化学反应速率是与硅表面的原子密度,也就是与表面的价键密度有关。(111)面上的硅原子密度比(100)面上大。因此,(111)面上的线性氧化速率常数应比(100)面上大。4)杂质影响掺磷/硼掺氯在干分子氧中加入少量(1%~3%)卤素能够显著改善SiO2特性:①加速反应Si-O键能为4.25eV,Si-Cl键能为0.5eV。氯气与Si反应生成的SiCl4可以与氧气反应生成SiO2,这里氯气起到了催化剂的作用。②Cl-能够中和积累在表面的电荷。③氯气能够与大多数重金属原子反应生成挥发性的金属氯化物,起到清洁作用。
17、问答题 假设进行一次受固溶度限制的预淀积扩散,从掺杂玻璃源引入的杂质总剂量为Qcm-2。
点击查看答案
本题答案:(1)如果这次预淀积进行了总共t分钟,若预淀积温度不变
本题解析:试题答案(1)如果这次预淀积进行了总共t分钟,若预淀积温度不变,引入3Qcm-2的杂质需要多长时间?(2)预淀积后再进行推进扩散,要求推进的杂质足够深,使得最后表面杂质浓度等于其固溶度Cs的1%。若已知预淀积过程中的(Dt)predop,推导出推进扩散过程中(Dt)drive-in的表达式。
18、问答题 简述常规热氧化办法制备SiO2介质薄膜的动力学过程,并说明在什么情况下氧化过程由反应控制或扩散控制。
点击查看答案
本题答案:迪尔-格罗夫氧化模型可以很好地预测氧化层厚度,热氧化过
本题解析:试题答案迪尔-格罗夫氧化模型可以很好地预测氧化层厚度,热氧化过程主要分为以下三个过程:(1)氧化剂从气体内部以扩散形式穿过滞留层运动到气体-SiO2界面,其流密度用J1表示。(2)氧化剂以扩散方式穿过SiO2层,到达SiO2-Si界面,其流密度用J2表示。(3)氧化剂在Si表面与Si反应生成SiO2,流密度用J3表示。
 当氧化剂在SiO2中的扩散系数DSiO2很小时(D<
当氧化剂在SiO2中的扩散系数DSiO2很小时(D<
19、问答题 根据曝光方式的不同,光学光刻机可以分成几类?各有什么优缺点?
点击查看答案
本题答案:根据曝光方式不同光学光刻机主要分为三种:接触式,接近式
本题解析:试题答案根据曝光方式不同光学光刻机主要分为三种:接触式,接近式,投影式。接触式:接触式光刻机是最简单的光刻机,曝光时,掩模压在涂有光刻胶的晶圆片上。主要优点:设备简单,分辨率高,没有衍射效应主要缺点:掩模版与涂有光刻胶的晶圆片直接接触,每次接触都会在晶圆片和掩模版上产生缺陷,降低掩模版使用寿命,成品率低,不适合大规模生产。接触式光刻机一般仅限用于能容忍较高缺陷水平的器件研究或其他方面的应用。接近式:接近式光刻机是掩模版同光刻胶间隔10~50μm,所以缺陷大大减少。主要优点:避免晶圆片与掩模直接接触,缺陷少。主要缺点:分辨率下降,存在衍射效应。
投影式:现今硅片光学曝光最主要的方法是投影式曝光。一般光学系统将光刻版上的图像缩小4x或5x倍,聚焦并与硅片上已有的图形对准后曝光,每次曝光一小部分,曝完一个图形后,硅片移动到下一个曝光位置继续对准曝光。主要优点:有接触式的分辨率,但不产生缺陷常用投影光刻机系统的类型有扫描光刻机、分步重复光刻机和扫描分步重复光刻机等。
20、问答题 从寄生电阻和电容、电迁移两方面说明后道工艺中(Back-End-Of-Line,BEOL)采用铜(Cu)互连和低介电常数(low-k)材料的必要性。
点击查看答案
本题答案:寄生电阻和寄生电容造成的延迟。电子在导电过程中会撞击导
本题解析:试题答案寄生电阻和寄生电容造成的延迟。电子在导电过程中会撞击导体中的离子,将动量转移给离子从而推动离子发生缓慢移动。该现象称为电迁移。在导电过程中,电迁移不断积累,并最终在导体中产生分散的缺陷。这些缺陷随后集合成大的空洞,造成断路。因此,电迁移直接影响电路的可靠性。采用铜互连可大幅降低金属互连线的电阻从而减少互连造成的延迟。铜的电迁移比铝材料小很多:铜的晶格扩散的激活能为2.2eV,晶界扩散结合能在0.7到1.2eV之间;而铝分别为1.4eV和0.4-0.8eV.采用低介电常数材料填充平行导线之间的空间可降低金属互连线之间的电容从而减少延迟。采用铜/low-k互连可大幅减小互连pitch,从而减少互连金属层数。
21、问答题 个投影曝光系统采用ArF光源,数值孔径为0.6,设k1=0.6,n=0.5,计算其理论分辨率和焦深。
点击查看答案
本题答案:分辨率: 试题答案分辨率:
试题答案分辨率:
焦深:
22、问答题
Si-SiO2界面电荷有哪几种?简述其来源及处理办法。

点击查看答案
本题答案:可动离子电荷Qm来源:主要来源于Na+等网络改变者。解
本题解析:试题答案可动离子电荷Qm来源:主要来源于Na+等网络改变者。解决办法:为了降低Na+的玷污,可以在工艺过程中采取预防措施包括①使用含氯的氧化工艺;②用氯周期性地清洗管道、炉管和相关的容器;③使用超纯净的化学物质;④保证气体及气体传输过程的清洁。另外保证栅材料不受玷污也是很重要的。氧化层陷阱电荷Qot来源:在氧化层中有些缺陷能产生陷阱,这些缺陷有:①悬挂键;②界面陷阱;⑤硅-硅键的伸展;④断键的氧原子(氧的悬挂键);⑤弱的硅-硅键(它们很容易破裂,面表现电学特性)。⑥扭曲的硅-氧键;⑦Si-H和Si-OH键。
产生陷阱电荷的方式主要有电离辐射和热电子注入等
解决办法:减少电离辐射陷阱电荷的主要方法有三种:①选择适当的氧化工艺条件以改善SiO2结构。为抗辐照,氧化最佳工艺条件,常用1000℃干氧氧化。②在惰性气体中进行低温退火(150-400℃)可以减少电离辐射陷阱。③采用对辐照不灵敏的钝化层,例如A12O3,Si3N4等。氧化层固定电荷Qf来源:通常是由Si-SiO2之间过渡区的结构改变引起的。该区中存在有过剩的硅离子,在氧化过程中与晶格脱开但还未完全与氧反应。处理办法:快速退火能有效地减小氧化层固定电荷密度。右图为Deal三角,说明了这种效应。界面陷阱电荷Qit来源:界面处存在的不完整化合价及不饱和键,使得电子和空穴可以很容易地被俘获。处理办法:界面态密度与衬底晶向、氧化层生长条件和退火条件密切有关。在相同的工艺条件下、(111)晶向的硅衬底产生的界面态密度最高,(100)晶向的最低。通过采用特殊的退火工艺可以有效减少界面态密度。
23、问答题 简述在热氧化过程中杂质再分布的四种可能情况。
点击查看答案
本题答案:如果假设硅中的杂质分布是均匀的,而且氧化气氛中又不含有
本题解析:试题答案如果假设硅中的杂质分布是均匀的,而且氧化气氛中又不含有任何杂质,则再分布有四种可能。①分凝系数m<l,且在SiO2中是慢扩散的杂质,也就是说在分凝过程中杂质通过SiO2表面损失的很少,硼就是属于这类。再分布之后靠近界面处的SiO2中的杂质浓度比硅中高,硅表面附近的浓度下降。②m<1,且在SiO2中是快扩散的杂质。因为大量的杂质通过SiO2表面跑到气体中去,杂质损失非常厉害,使SiO2中的杂质浓度比较低,但又要保证界面两边的杂质浓度比小于1,使硅表面的杂质浓度几乎降到零,在H2气氛中的硼就属于这种情况。③m>1,且在SiO2中慢扩散的杂质。再分布之后硅表面附近的杂质浓度升高,磷就属于这种杂质。④m>l,且在SiO2中快扩散的杂质。在这种情况下,虽然分凝系数大于1,但因大量杂质通过SiO2表面进入气体中而损失,硅中杂质只能不断地进入SiO2中,才能保持界面两边杂质浓度比等于分凝系数,最终使硅表面附近的杂质浓度比体内还要低,镓就是属于这种类型的杂质。对于m=1,而且也没有杂质从SiO2表面逸散的情况,热氧化过程也同样使硅表面杂质浓度降低。这是因为一个体积的硅经过热氧化之后转变为两个多体积的SiO2,由此,要使界面两边具有相等的杂质浓度(m=1),那么杂质必定要从高浓度硅中向低浓度SiO2中扩散,即硅中要消耗一定数量的杂质,以补偿增加的SiO2体积所需要的杂质。
24、问答题 采用无定形掩膜的情况下进行注入,若掩蔽膜/衬底界面的杂质浓度减少至峰值浓度的1/10000,掩蔽膜的厚度应为多少?用注入杂质分布的射程和标准偏差写出表达式。
点击查看答案
本题答案:无定形靶内的纵向浓度分布可用高斯函数表示:
本题解析:试题答案无定形靶内的纵向浓度分布可用高斯函数表示:
 其中,Rp为投影射程,ΔRp为投影射程的标准偏差,φ为剂量。以上为浓度与深度的函数变化关系。由于离子注入过程的统计特性,离子也有穿透掩蔽膜边缘的横向散射,因此分布应考虑为二维的,既有横向也有纵向的标准偏差。射程估算:如果注入离子能量比Ec大很多,则离子在靶内主要以电子阻止形式损失能量,可按下式估算射程:R≈K1E1/2如果注入离子的能量E<<Ec,离子在靶内主要以核阻止形式损失能量,则得射程R的表达式为:R≈K2E
其中,Rp为投影射程,ΔRp为投影射程的标准偏差,φ为剂量。以上为浓度与深度的函数变化关系。由于离子注入过程的统计特性,离子也有穿透掩蔽膜边缘的横向散射,因此分布应考虑为二维的,既有横向也有纵向的标准偏差。射程估算:如果注入离子能量比Ec大很多,则离子在靶内主要以电子阻止形式损失能量,可按下式估算射程:R≈K1E1/2如果注入离子的能量E<<Ec,离子在靶内主要以核阻止形式损失能量,则得射程R的表达式为:R≈K2E
25、问答题 什么是光刻中常见的表面反射和驻波效应?如何解决?
点击查看答案
本题答案:表面反射——穿过光刻胶的光会从
本题解析:试题答案表面反射——穿过光刻胶的光会从晶圆片表面反射出来,从而改变投入光刻胶的光学能量。当晶圆片表面有高度差时,表面反射会导致线条的缺失,无法控制图形。针对表面反射效应的解决办法:①改变沉积速率以控制薄膜的反射率②避免薄膜表面高度差,表面平坦化处理(CMP)③光刻胶下涂覆抗反射的聚合物(Anti-reflectcoating,ARC.
驻波效应——在微细图形光刻时,一般曝光光源为单色或窄带光源,在由基片、氧化物层和抗蚀剂等组成的多层膜系情况下,由于膜系各层折射率不同,曝光时在基底表面产生的反射光和入射光相互干涉而形成驻波。抗蚀剂在曝光过程中由于其折射率和基底材料折射率不匹配,入射光将在各层膜的界面处发生多次反射,在光致抗蚀剂中形成驻波。应用抗反射涂层(ARC.可以完全消除驻波图形。
26、问答题 热蒸发法淀积薄膜的淀积速率与哪些因素有关?淀积速率的测量采用什么办法?
点击查看答案
本题答案:简述其工作原理。淀积速率与蒸发材料温度腔体形状等因素有
本题解析:试题答案简述其工作原理。淀积速率与蒸发材料温度腔体形状等因素有关。淀积速率通常用石英晶体速率指示仪测量。所用器件为一个谐振板,它可以在谐振频率下振荡,工作时测量其振荡频率。原理:因为晶体顶部有材料蒸发淀积,所外加的质量将使得频率偏移,由测得的频率移动可得出淀积速率。淀积足够厚的材料后,谐振频率会移动几个百分点,振荡器便会失效,不再出现尖锐谐振。将频率测量系统的输出与机械挡板的控制相连,淀积层厚度可以在很宽的淀积速率范围内得到很好的控制。同时可以将淀积厚度的时间速率变化反馈给坩埚的温度控制,以得到恒定的淀积速率。
27、问答题
下图为一个典型的离子注入系统。(1)给出1~6数字标识部分的名称,简述其作用。(2)阐述部件2的工作原理。

点击查看答案
本题答案:1.离子源2.分析磁块3.加速器4.中性束闸5.x&a
本题解析:试题答案1.离子源2.分析磁块3.加速器4.中性束闸5.x&y扫描板6.法拉第杯
1.离子源作用:产生注入用的离子原理:高能电子轰击(电子放电)杂质原子形成注入离子类型:高频,电子振荡,溅射气体流入一个放电腔室,热灯丝发射的电子与气体分子碰撞,当能量足够大时,气体分子被离化。2.质量分析器作用:将所需离子分选出来原理:带电离子在磁场中受洛伦磁力作用,运动轨迹发生弯曲由离子源引出的离子流含有各种成分,其中大多数是电离的,在BF3的例子中,我们需要仅仅拣选出B+,这样的过程通常由一个分析磁铁完成。离子束进入一个低压腔体内,该腔体内的磁场方向垂直于离子束的速度方向,利用磁场对荷质比不同的离子产生的偏转作用大小不同,最后在特定位置采用一个狭缝,可以将所需的离子分离出来。 3.加速器作用:使离子获得所需的能量。原理:利用强场,使离子获得更大的速度加速器的主要作用是使离子增加离子能量能够达到器件所需要的结深。用一组静电透镜将束聚焦为一个圆斑或长条状,然后束进入一个线性静电加速器,加速器沿加速管的长度方向建立一个电场来改变离子的能量。4.中性束闸和中性束阱作用:使中性原子束因直线前进不能达到靶室原理:用一静电偏转板使离子束偏转5º--8º作用再进入靶室5.扫描系统作用:使离子在整个靶片上均匀注入。方式:①靶片静止,离子束在X,Y方向作电扫描。②粒子束在Y方向作电扫描,靶片在X方向作机械运动。③粒子束静止,靶片在X,Y方向作机械运动。6.法拉第杯作用:收集束流测量注入剂量原理:收集到的束流对时间进行积分得到束流的大小信息
3.加速器作用:使离子获得所需的能量。原理:利用强场,使离子获得更大的速度加速器的主要作用是使离子增加离子能量能够达到器件所需要的结深。用一组静电透镜将束聚焦为一个圆斑或长条状,然后束进入一个线性静电加速器,加速器沿加速管的长度方向建立一个电场来改变离子的能量。4.中性束闸和中性束阱作用:使中性原子束因直线前进不能达到靶室原理:用一静电偏转板使离子束偏转5º--8º作用再进入靶室5.扫描系统作用:使离子在整个靶片上均匀注入。方式:①靶片静止,离子束在X,Y方向作电扫描。②粒子束在Y方向作电扫描,靶片在X方向作机械运动。③粒子束静止,靶片在X,Y方向作机械运动。6.法拉第杯作用:收集束流测量注入剂量原理:收集到的束流对时间进行积分得到束流的大小信息
28、问答题 MEMSSi加工工艺主要分为哪两类,它们最基本的区别是什么?
点击查看答案
本题答案:Si工艺 体硅微机械加工工艺(Bulkmicromac
本题解析:试题答案Si工艺 体硅微机械加工工艺(Bulkmicromaching)——用晶圆自身材料来制作MEMS结构优势:可用于制作大的深宽比、很厚的结构表面微机械加工工艺(Surfacemicromachining)——与IC工艺兼容 牺牲层制作 阻挡层制作 牺牲层释放工艺
29、问答题 什么是离子分布的偏斜度和峭度,和标准高斯分布有什么区别?
点击查看答案
本题答案:非对称性常用偏斜度γ(skewness)表
本题解析:试题答案非对称性常用偏斜度γ(skewness)表示: γ为负值表明杂质分布在表面一侧的浓度增加,即x<Rp区域浓度增加。畸变用峭度β(kurtosis)表示:
γ为负值表明杂质分布在表面一侧的浓度增加,即x<Rp区域浓度增加。畸变用峭度β(kurtosis)表示: 峭度越大,高斯曲线的顶部越平,标准高斯曲线的峭度为3。LSS的理论是呈标准的高斯分布,不同的杂质会不同程度地偏离对称的高斯分布。如图中所示。
峭度越大,高斯曲线的顶部越平,标准高斯曲线的峭度为3。LSS的理论是呈标准的高斯分布,不同的杂质会不同程度地偏离对称的高斯分布。如图中所示。
30、问答题 射频放电与直流放电相比有何优点?
点击查看答案
本题答案:直流放电中,电荷在表面的积聚会使电场减小,直到等离子体
本题解析:试题答案直流放电中,电荷在表面的积聚会使电场减小,直到等离子体消失。在射频电场中,因为电场周期性地改变方向,带电粒子不容易到达电极和器壁而离开放电空间,相对地减少了带电粒子的损失。在两极之间不断振荡运动的电子可以从高频电场中获得足够的能量使气体分子电离,只要有较低的电场就可以维持放电。阴极产生的二次电子发射不再是气体击穿的必要条件。射频电场可以通过任何一种类型的阻抗耦合进入淀积室,所以电极可以是导体,也可是绝缘体。
点击进入《★半导体芯片制造工》题库
点击进入《半导体芯片制造工:半导体制造技术》考试资料、试题下载,试卷在线测试